|
|
摘要 g3(LDqB�'.
�:k��d]n$]
 r5N��H*�\Q L�bR'n�G{J 在半導(dǎo)體工業(yè)中,晶片檢測(cè)系統(tǒng)被用來(lái)檢測(cè)晶片上的缺陷并找到它們的位置。為了確保微結(jié)構(gòu)所需的圖像分辨率,檢測(cè)系統(tǒng)通常使用高NA物鏡,并且工作在UV波長(zhǎng)范圍內(nèi)。作為例子,我們建立了包括高NA聚焦和光與微結(jié)構(gòu)相互作用的完整晶片檢測(cè)系統(tǒng)的模型,并演示了成像過(guò)程。 &�+yo��P�F |ZOd�fr4uW r5N��H*�\Q L�bR'n�G{J 在半導(dǎo)體工業(yè)中,晶片檢測(cè)系統(tǒng)被用來(lái)檢測(cè)晶片上的缺陷并找到它們的位置。為了確保微結(jié)構(gòu)所需的圖像分辨率,檢測(cè)系統(tǒng)通常使用高NA物鏡,并且工作在UV波長(zhǎng)范圍內(nèi)。作為例子,我們建立了包括高NA聚焦和光與微結(jié)構(gòu)相互作用的完整晶片檢測(cè)系統(tǒng)的模型,并演示了成像過(guò)程。 &�+yo��P�F |ZOd�fr4uW
任務(wù)描述 v
<OZ
#
L$ ]�3� QW\k~
 � ��#J�� � ��#J��
#WAX�&<��m 微結(jié)構(gòu)晶圓 �g~7�6c.u-
z8xBq%97us
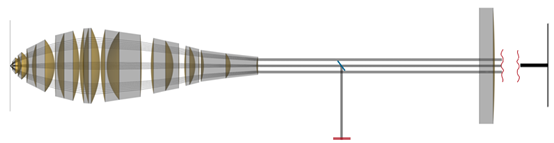 g1Osd�7\�o g1Osd�7\�o
//%#?�JJV�
 R{Cbp�=3J R{Cbp�=3J
0�!�t��uUn
 @�7{.err!� s5)y�%,��E 通過(guò)在堆棧中定義適當(dāng)形狀的表面和介質(zhì)來(lái)模擬諸如在晶片上使用的周期性結(jié)構(gòu)的柵格結(jié)構(gòu)。然后,該堆棧可以導(dǎo)入到各種不同的組件中,具體取決于預(yù)期用途。在這種情況下,我們將堆棧加載到一般光學(xué)設(shè)置中的一個(gè)光柵組件中,以便模擬整個(gè)系統(tǒng)。有關(guān)詳細(xì)信息,請(qǐng)參閱:用于通用光學(xué)系統(tǒng)的光柵元件 �Gz(l~!n~a eDv�h�3Y<D 微結(jié)構(gòu)晶片的角度響應(yīng) �%�al
5� { @�7{.err!� s5)y�%,��E 通過(guò)在堆棧中定義適當(dāng)形狀的表面和介質(zhì)來(lái)模擬諸如在晶片上使用的周期性結(jié)構(gòu)的柵格結(jié)構(gòu)。然后,該堆棧可以導(dǎo)入到各種不同的組件中,具體取決于預(yù)期用途。在這種情況下,我們將堆棧加載到一般光學(xué)設(shè)置中的一個(gè)光柵組件中,以便模擬整個(gè)系統(tǒng)。有關(guān)詳細(xì)信息,請(qǐng)參閱:用于通用光學(xué)系統(tǒng)的光柵元件 �Gz(l~!n~a eDv�h�3Y<D 微結(jié)構(gòu)晶片的角度響應(yīng) �%�al
5� {
zU_��dk'&,
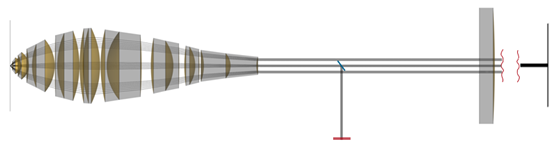 n��wIj?(8x n��wIj?(8x
 (��;-�_j�/ <-�,y0Y��' 該光柵組件使用傅里葉模態(tài)法(FMM),也稱為嚴(yán)格耦合波分析(RCWA),其運(yùn)作在k域中。當(dāng)入射大NA光束時(shí),需要考慮在k域中有足夠數(shù)量的采樣點(diǎn)來(lái)解決角度敏感效應(yīng)。在光柵組件的求解器區(qū)域中,用戶可以輕松地調(diào)整此參數(shù),以確保快速而準(zhǔn)確的模擬。 �#��q�eC)T SI�c~cZ!Yu (��;-�_j�/ <-�,y0Y��' 該光柵組件使用傅里葉模態(tài)法(FMM),也稱為嚴(yán)格耦合波分析(RCWA),其運(yùn)作在k域中。當(dāng)入射大NA光束時(shí),需要考慮在k域中有足夠數(shù)量的采樣點(diǎn)來(lái)解決角度敏感效應(yīng)。在光柵組件的求解器區(qū)域中,用戶可以輕松地調(diào)整此參數(shù),以確保快速而準(zhǔn)確的模擬。 �#��q�eC)T SI�c~cZ!Yu
大NA物鏡 :���39a�rq
�E�S�8(�:5
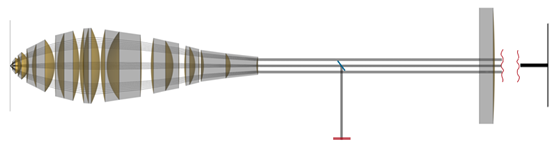 s s
|