半導(dǎo)體芯片生產(chǎn)主要分為 IC 設(shè)計(jì)、 IC 制造、 IC 封測(cè)三大環(huán)節(jié)。 IC 設(shè)計(jì)主要根據(jù)芯片的設(shè)計(jì)目的進(jìn)行邏輯設(shè)計(jì)和規(guī)則制定,并根據(jù)設(shè)計(jì)圖制作掩模以供后續(xù)光刻步驟使用。 IC 制造實(shí)現(xiàn)芯片電路圖從掩模上轉(zhuǎn)移至硅片上,并實(shí)現(xiàn)預(yù)定的芯片功能,包括光刻、刻蝕、離子注入、薄膜沉積、化學(xué)機(jī)械研磨等步驟。 IC 封測(cè)完成對(duì)芯片的封裝和性能、功能測(cè)試,是產(chǎn)品交付前的最后工序。
�VW,"
dm�C � 'Dh�+v3O  ���.��1O
���.��1O
芯片制造核心工藝主要設(shè)備全景圖
光刻是半導(dǎo)體芯片生產(chǎn)流程中最復(fù)雜、最關(guān)鍵的工藝步驟,耗時(shí)長(zhǎng)、成本高。半導(dǎo)體芯片生產(chǎn)的難點(diǎn)和關(guān)鍵點(diǎn)在于將電路圖從掩模上轉(zhuǎn)移至硅片上,這一過(guò)程通過(guò)光刻來(lái)實(shí)現(xiàn), 光刻的工藝水平直接決定芯片的制程水平和性能水平。芯片在生產(chǎn)中需要進(jìn)行 20-30 次的光刻,耗時(shí)占到 IC 生產(chǎn)環(huán)節(jié)的 50%左右,占芯片生產(chǎn)成本的 1/3。
>ic�L,�n"] a.�oZ}R7'Y 光刻工藝流程詳解
QH?}uX'x)G $}�9.4`�F> 光刻的原理是在硅片表面覆蓋一層具有高度光敏感性光刻膠,再用光線(一般是紫外光、深紫外光、極紫外光)透過(guò)掩模照射在硅片表面,被光線照射到的光刻膠會(huì)發(fā)生反應(yīng)。此后用特定溶劑洗去被照射/未被照射的光刻膠, 就實(shí)現(xiàn)了電路圖從掩模到硅片的轉(zhuǎn)移。
wK0= I\WN9 K�INK�q`Sx 光刻完成后對(duì)沒(méi)有光刻膠保護(hù)的硅片部分進(jìn)行刻蝕,最后洗去剩余光刻膠, 就實(shí)現(xiàn)了半導(dǎo)體器件在硅片表面的構(gòu)建過(guò)程。
�vZ��<@m2� Ru1I,QvCj" 光刻分為正性光刻和負(fù)性光刻兩種基本工藝,區(qū)別在于兩者使用的光刻膠的類型不同。負(fù)性光刻使用的光刻膠在曝光后會(huì)因?yàn)榻宦?lián)而變得不可溶解,并會(huì)硬化,不會(huì)被溶劑洗掉,從而該部分硅片不會(huì)在后續(xù)流程中被腐蝕掉,負(fù)性光刻光刻膠上的圖形與掩模版上圖形相反。
W�0++q�=F� 6f$h1�$$)^ 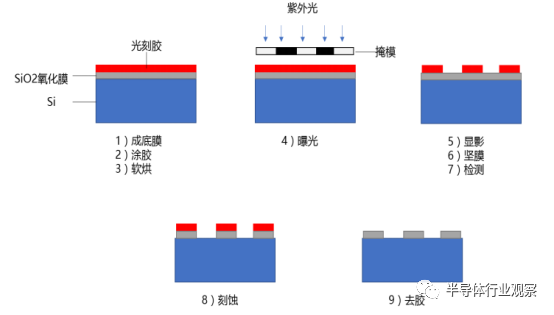 \|OW�`7Q)k
\|OW�`7Q)k 在硅片表面構(gòu)建半導(dǎo)體器件的過(guò)程
正性光刻與負(fù)性光刻相反,曝光部分的光刻膠會(huì)被破壞從而被溶劑洗掉,該部分的硅片沒(méi)有光刻膠保護(hù)會(huì)被腐蝕掉,正性光刻光刻膠上的圖形與掩模版上圖形相同。
~�-1!?t�/% 81(.{Y839_ 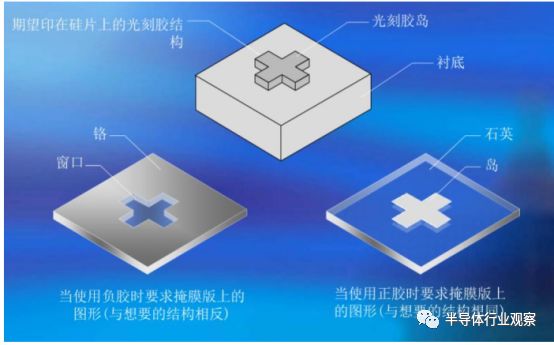 �9�P��pPAF
�9�P��pPAF 正性光刻與負(fù)性光刻對(duì)比
1)氣相成底膜
.:<-E��%�� I eQ�F+X�z 硅片在清洗、烘培后首先通過(guò)浸泡、噴霧或化學(xué)氣相沉積(CVD)等工藝用六甲基二胺烷成底膜,底膜使硅片表面疏離水分子,同時(shí)增強(qiáng)對(duì)光刻膠的結(jié)合力。底膜的本質(zhì)是作為硅片和光刻膠的連接劑,與這些材料具有化學(xué)相容性。
��;k<n}shD 9`3%o9V9Y 2)旋轉(zhuǎn)涂膠
Cf�z020u`g 3��1�9� &: 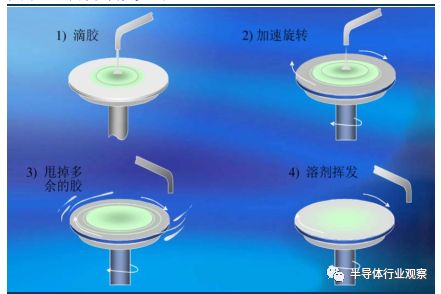 K1v�m
[Ne�
K1v�m
[Ne� 旋轉(zhuǎn)涂膠步驟
形成底膜后,要在硅片表面均勻覆蓋光刻膠。此時(shí)硅片被放置在真空吸盤上,吸盤底部與轉(zhuǎn)動(dòng)電機(jī)相連。當(dāng)硅片靜止或旋轉(zhuǎn)的非常緩慢時(shí),光刻膠被分滴在硅片上。隨后加速硅片旋轉(zhuǎn)到一定的轉(zhuǎn)速,光刻膠借助離心作用伸展到整個(gè)硅片表面,并持續(xù)旋轉(zhuǎn)甩去多余的光刻膠,在硅片上得到均勻的光刻膠膠膜覆蓋層,旋轉(zhuǎn)一直到溶劑揮發(fā),光刻膠膜幾乎干燥后停止。
��'�h?;i2[ P^1+;dL,�D